| Главная » Статьи » ИСТОЧНИКИ ПИТАНИЯ |
Проблемы выбора ключевых транзисторов
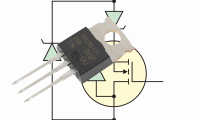 В статье рассматриваются вопросы выбора
полупроводниковых ключевых приборов для преобразовательной техники.
Приводится методика быстрого оценочного расчета потерь в инверторах и
оценка эффективности применения перспективных транзисторов.
В статье рассматриваются вопросы выбора
полупроводниковых ключевых приборов для преобразовательной техники.
Приводится методика быстрого оценочного расчета потерь в инверторах и
оценка эффективности применения перспективных транзисторов.За последнее время MOSFET и IGBT-транзисторы надежно зарекомендовали себя в качестве основных ключевых приборов для преобразовательной техники. В литературе [1-3] достаточно подробно рассматривался вопрос выбора тех или иных приборов в зависимости от величин рабочих частот, токов, напряжений и режимов работы транзисторов. Рис. 1 иллюстрирует общепринятое разграничение областей применения MOSFET и IGBT в жестком режиме переключения исходя из достижимых для коммерческого использования их основных электрических характеристик. 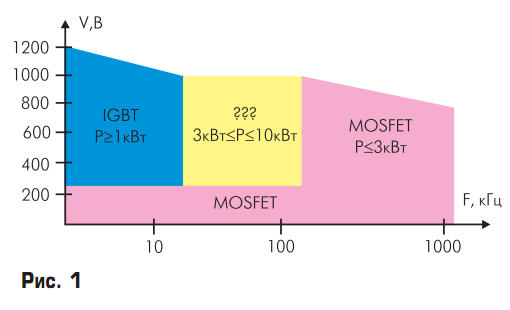 При напряжениях питания до 250 В и на частотах переключения свыше 100 кГц доминирующую роль играют MOSFET-транзисторы, на частотах до 30 кГц и напряжении 300-1200 В предпочтение отдается IGBT, при этом диапазон 250-800 В при 30-150 кГц оказывается спорным с позиции эффективности использования того или иного прибора. Это связано с тем, что у IGBT существенную роль начинают играть динамические потери, а у MOSFET — статические, обусловленные слишком большой величиной сопротивления в открытом состоянии. Еще один важный фактор, влияющий на выбор ключевых приборов, связан со спецификой работы рассматриваемых преобразователей на индуктивную нагрузку и заключается в необходимости установки антипараллельных диодов, характеристики обратного восстановления которых вносят значительный вклад в динамические потери. За последние годы ведущие производители компонентов для силовой электроники предприняли значительные усилия как по улучшению характеристик традиционных полупроводниковых приборов, так и по разработке новых изделий, позволяющих разработчикам решать проблемы повышения эффективности преобразователей на качественно новом уровне. Это заставляет пересмотреть традиционные решения вопроса выбора типов ключевых транзисторов. Ниже будут рассмотрены характеристики современных силовых приборов и предложена методика выбора исходя из соотношения «эффективность — стоимость». MOSFET-транзисторыПоявление в 70-х годах прошлого века высоковольтных полевых транзисторов с вертикальной структурой произвело переворот в схемотехнике и характеристиках источников вторичного электропитания (ИВЭП). Высокие скорости переключения, отсутствие насыщения, простота управления затворами, устойчивость к перегрузкам по току и dV/dt позволили проектировать ИВЭП с частотами преобразования до сотен килогерц и удельными мощностями свыше 1000 Вт/дм3. В то же время по статическим потерям MOSFET значительно проигрывали биполярным транзисторам и тиристорам, что ограничивало их применение в мощных преобразователях. Поэтому основные усилия фирм-производителей были направлены на уменьшение величины сопротивления в открытом состоянии и увеличение максимального напряжения «сток — исток».В 1998 году компания Infineon Technologies представила новый тип MOSFET-транзисторов под торговой маркой CoolMOS с напряжением «сток — исток» в закрытом состоянии 600 и 800 В, в которых удалось снизить сопротивление в открытом состоянии более чем в 5 раз по сравнению с обычными полевыми транзисторами с вертикальной структурой. Помимо сверхнизких статических потерь транзисторы CoolMOS обеспечивают более высокую, чем у MOSFET, скорость переключения благодаря меньшей площади кристалла и, как следствие, более низкие потери переключения. Общим недостатком полевых транзисторов с вертикальной структурой является наличие паразитного антипараллельного диода с неудовлетворительными характеристиками обратного восстановления, что очень усложняет их использование в преобразователях с рекуперацией реактивной энергии («жесткое переключение», индуктивная нагрузка, резонансные инверторы [4] и т. п.). Это заставляет производителей разрабатывать технологии, позволяющие улучшить характеристики встроенного диода. Примером может служить семейство транзисторов HiPerFET компании IXYS. Второй подход к решению данной проблемы заключается в блокировке паразитного диода последовательным с транзистором диодом Шоттки и подключении встречно-параллельно диода ULTRAFAST или SiC (рис. 2). Приборы, реализующие этот принцип, выпустила компания Advanced Power Technology. Однако наличие последовательного диода резко увеличивает статические потери по сравнению с одиночным MOSFET. 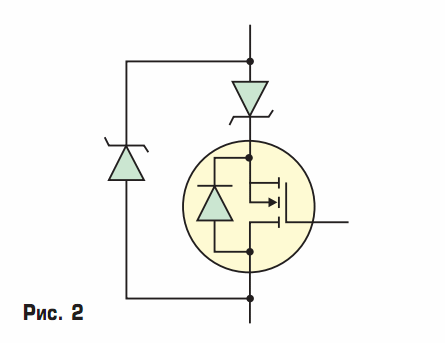 Для сравнения в таблице 1 приведены характеристики новых приборов с классификационными напряжениями 600 и 800 В и постоянным током стока до 55 А, изготовленных по различным технологиям. Таблица 1 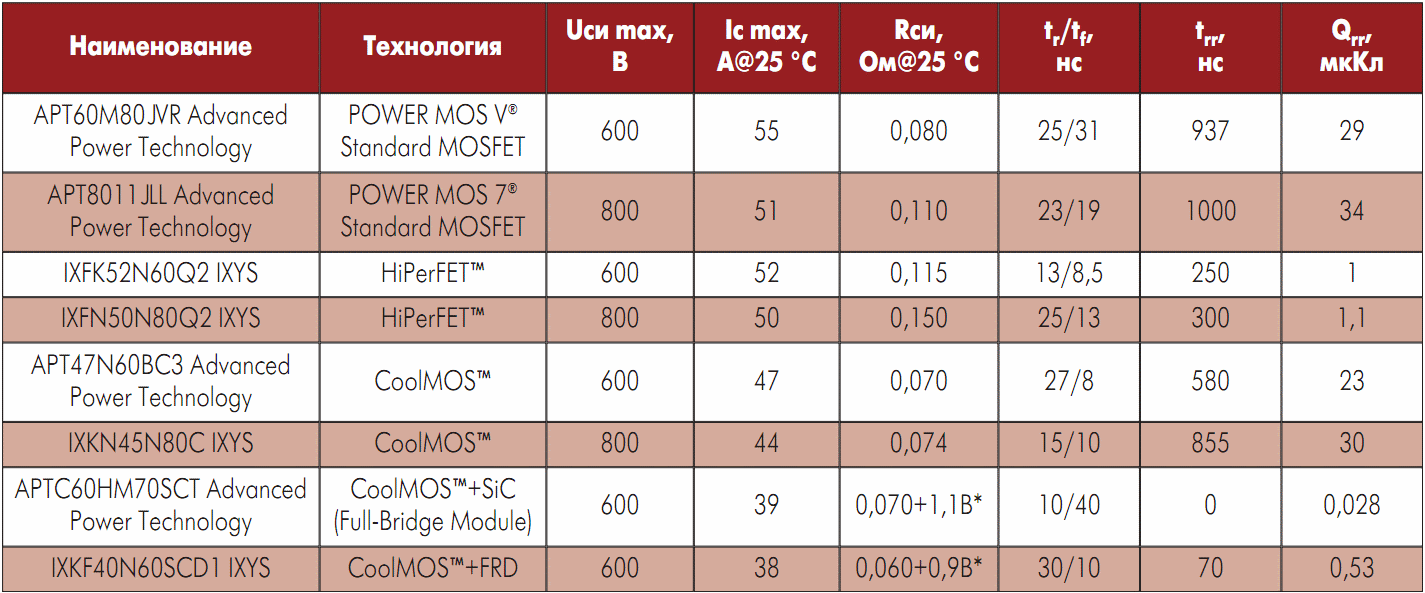 * Указано сопротивление в открытом состоянии плюс прямое падение напряжения на последовательном блокирующем диоде Шоттки. * Указано сопротивление в открытом состоянии плюс прямое падение напряжения на последовательном блокирующем диоде Шоттки.IGBT-транзисторыОтмеченные выше недостатки полевых транзисторов заставляли производителей силовых полупроводников искать компромиссное решение, позволяющее объединить достоинства MOSFET и биполярных транзисторов Дарлингтона. В конце 80-х годов прошлого века было создано первое поколение биполярных транзисторов с изолированным затвором (IGBT), а в начале 90-х — второе и третье поколения. Эти приборы объединили в себе простоту управления затвором полевого и большие коммутируемые токи биполярного транзисторов.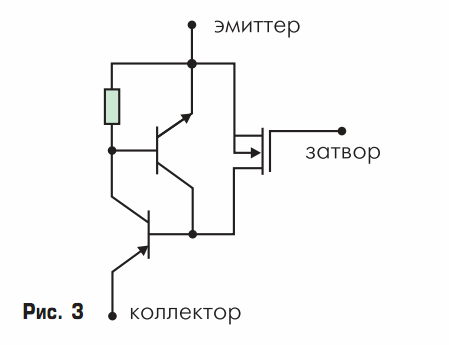 Упрощенно IGBT можно представить как комбинацию биполярного р-п-р-транзистора и MOSFET (рис. 3). Помимо основного р-п-р-транзистора существует паразитная n-р-n-структура, которую делают неактивной путем шунтирования база-эмиттерного перехода слоем металлизации истока. Эти два транзистора образуют четырехслойную р-п-р-п-структуру паразитного тиристора. Суммарное усиление п-р-п- и р-п-р-транзисторов должно быть меньше 1. Однако с повышением температуры их усиление возрастает, поэтому при очень большом токе коллектора из-за локального нагрева их суммарное усиление может превысить 1 и привести к открыванию п-р-п-транзистора. При этом паразитный тиристор отпирается и не реагирует на изменение напряжения на затворе, что может привести к выходу из строя IGBT. Этот эффект называют статическим защелкиванием. Чрезмерно высокие величины dVкэ/dt и dIr/dt при выключении также могут привести к открыванию п-р-п-транзистора. Это эффект динамического защелкивания, который приводит к уменьшению области безопасной работы IGBT и делает ее зависимой от скорости выключения dVкэ/dt. В отличие от MOSFET, у IGBT отсутствует интегральный паразитный обратный диод, что позволяет при необходимости использовать внешний антипараллельный диод ULTRAFAST или SiC. Структурно IGBT делятся на РТ (punch-through) и NPT (non-punch-through). У РТ-приборов дополнительно имеется п+ буферный слой между р+ подложкой и п- эпитаксиальной областью (рис. 4).  Благодаря его наличию увеличивается скорость рекомбинации дырок, что приводит к увеличению скорости выключения транзистора и уменьшению времени и тока рассасывания, а также усиления р-п-р-транзистора. У NPT IGBT п+ буферный слой отсутствует, что, с одной стороны, приводит к уменьшению прямого падения напряжения «коллектор — эмиттер», но с другой стороны — увеличивает время рассасывания и, соответственно, потери выключения на высоких частотах. РТ IGBT, в отличие от более «медленных» NPT-приборов, обладают низкой устойчивостью к короткому замыканию и поглощению большой лавинной энергии. По скорости переключения РТ IGBT могут сравниваться с мощными MOSFET-транзисторами, поэтому усилия фирм-производителей направлены на снижение прямых потерь проводимости и увеличение устойчивости к dVкэ/dt Современные РТ IGBT, например из производственной линейки PowerMOS7 компании Advanced Power Technology, благодаря технологии снижения толщины п- эпитаксиальной области имеют величину прямого падения напряжения не хуже, чем у NPT-приборов. В таблице 2 приведены характеристики современных высокоскоростных РТ и NPT IGBT с классификационными напряжениями 600 и 1200 В, постоянным током коллектора до 50 А и антипараллельным диодом (FRD). Таблица 2  Выбор ключевых транзисторовВ рамках данной статьи интерес представляет анализ эффективности применения того или иного класса ключевых приборов в преобразователях с напряжением питания 300-600 В мощностью до 10 кВт с частотами преобразования свыше 50 кГц. Такая задача относится к большой группе аппаратуры, которая включает установки для индукционного нагрева средней мощности (пайка и закалка), источники бесперебойного питания, прецизионные системы управления электродвигателями и т. п.Выбор того или иного прибора в общем случае определяется конкретными электрическими характеристиками системы в целом. Критерием оптимальности в первом приближении можно считать минимизацию суммарных потерь при заданных параметрах питания и мощности нагрузки при максимально допустимом увеличении стоимости преобразователя. Для оценки величин потерь в преобразователе, работающем в «жестком» режиме, будем считать, что за время открытого состояния транзистора ток, протекающий через него, остается приблизительно постоянным, скорость нарастания напряжения при выключении определяется величиной tf коэффициент заполнения равен 0,5. Мощности статических потерь определяются выражениями: • для MOSFET  • для MOSFET по схеме рис. 2  • для IGBT  где Isw — ток, протекающий через транзистор; Usat — прямое падение напряжения на IGBT; Ron — сопротивление MOSFET в открытом состоянии; Ud— прямое падение напряжения блокирующего диода. Мощность динамических потерь складывается из трех составляющих: «жесткое» переключение при токе (Isw), разряд выходной емкости (С22) транзистора, заряженной до уровня напряжения питания (V0), обратное восстановление антипараллельного диода с зарядом (Qrr), и определяется выражениями: • для MOSFET  • для IGBT  где tr, tf— время нарастания и спада тока через транзистор;fs — частота преобразования; Еtot — суммарная энергия переключения IGBT. Полные потери: В таблице 3 приведены результаты расчетов величин полных потерь для приведенных выше приборов, работающих в преобразователях с V0 = 320 В, Р0 = 5 кВт и V0 = 540 В, Р0= 10 кВт на частоте fs = 100 кГц. Таблица 3  Примечание: цветом выделены приборы, неприемлемые для данного применения.  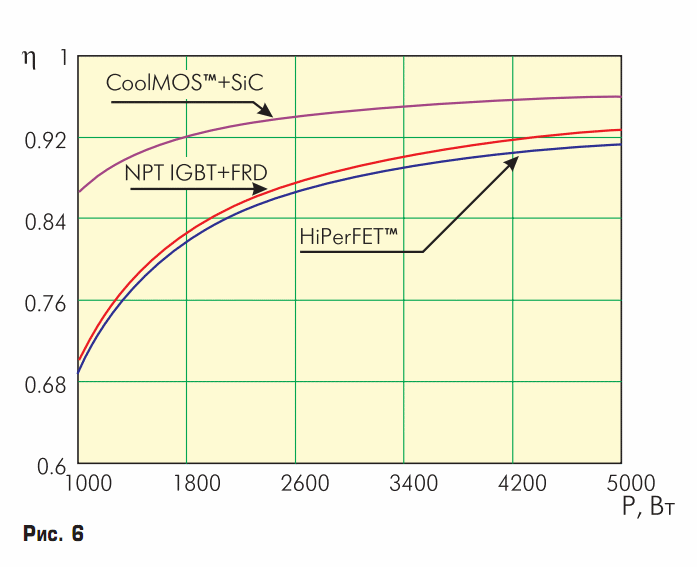 На рис. 5,6 показаны зависимости суммарных потерь и КПД мостовых инверторов от частоты переключения и мощности при использовании транзисторов IXFK52N60Q2 (HiPerFET), IRGP50B60PD1 (NPTIGBT+FRD) и модуля APTC60HM70SCT (CoolMOS+SiC). Хорошо видно, что КПД во всех случаях определяется в основном динамическими потерями. Использование HiPerFET и высокоскоростных NPT IGBT-приборов со встроенными FRD на частотах выше 50 кГц дает приблизительно одинаковый результат. Радикальный выигрыш на высоких частотах получается при использовании транзисторов CoolMOS с антипараллельными диодами из карбида кремния, однако стоимость инвертора при этом значительно возрастает (с $30 за четыре IRGP50B60PD1 до $160 за модуль APTC60HM70SCT). Выводы, которые можно сделать из приведенных расчетов, вполне ожидаемы: во-первых, паразитные диоды стандартных MOSFET и CoolMOS не могут быть использованы в качестве рекуперационных при работе с «жестким» переключением на индуктивную нагрузку; во-вторых, в рассматриваемом режиме работы частоты переключения современных 1200-вольтовых NPT IGBT не превышают 20-30 кГц, хотя последние позиционируются как ULTRAFAST приборы. В то же время хорошие результаты показывают новые HiPerFET и комбинированные CoolMOS. Вопрос о применении РТ IGBT для жесткого переключения должен решаться в каждом конкретном случае индивидуально, поскольку, как отмечалось выше, они не обладают устойчивостью к поглощению больших величин лавинной энергии. Комбинация CoolMOS и диода Шоттки SiC, как показано на рис. 2, фактически является идеальной альтернативой IGBT для высоких частот переключения. Особенно перспективно, по мнению автора, использование готовых полумостовых и мое-товых модулей, в которых уже решены проблемы получения низких тепловых сопротивлений, электрической изоляции кристаллов и оптимизации конструкции с целью сниже ния паразитных реактивностей. При этом реальная стоимость мостового инвертора в виде модуля CoolMOS+SiC и собранного на дискретных HiPerFET-транзисторах с учетом конструктивных затрат практически одинакова. Таким образом, возвращаясь к вопросу о применимости IGBT или MOSFET в спорном диапазоне рабочих напряжений и частот (рис. 1), можно с уверенностью сказать, что в ближайшие несколько лет ответ на него будет в пользу последних. Александр Полищук hvl-alex@rambler.ru
Литература1. C. Blake, C. Bull. IGBT or MOSFET: Choose Wisely. International Rectifier. 1989.2. A. Dubhashi, B. Pelly. IGBT vs HEXFET Power MOSFETs For Variable Frequency Motor Drives. International Rectifier. 1987. AN-980. 3. J. Dodge. Latest Technology PT IGBTs vs. Power MOSFETs. Advanced Power Technology. PCIM China. 2003. 4. L. Lorenz, G. Deboy, A. Knapp, M. Marz. CoolMOS — a new milestone in high voltage power MOS // Proc. of the ISPSD, 99–102. 1999. 5. H. Kim, Tomas M. Jahns, G. Venkataramanan. Minimization of Reverse Recovery Effects in Hard-Switched Inverters using CoolMOS Power Switches // IEEE IAS Annual Meeting. 2001. | |
| Просмотров: 4985 | | |
| Всего комментариев: 0 | |